II dio Mikroprocesor
2.7. Pakovanje
U početku, za osnovu na kojoj su montirani mikroprocesorski čipovi korišćena je keramika, dok su veze obezbjeđivane spajanjem samo na krajevima matrice. Ova tehnologija je nazvana DIP (eng. Dual-in-line Packages) odnosno CERDIP (eng. CERamic DIP). Kod ove tehnologije broj kontakata (eng. pin) je bio relativno mali (≤40) kao i brzina rada (≤20MHz).
 |
 |
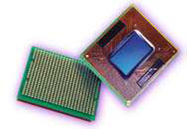 |
| Slika 10: 40-to iglično DIP pakovanje | Slika 11: Pentium sa keramičkim PGA | Slika 12: Pentium II (microPGA pakovanje) |
 |
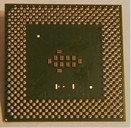 |
 |
| Slika 13: Pentium 3 sa kertridž pakovanjem | Slika 14: FC-PGA pakovanje | Slika 15: FC-BGA pakovanje procesora procesora (Pentium III) |
Kasnije, nove mogućnosti mikroprocesora (povećanje radnog takta, U/I prekidi) su zahtijevale povećan broj pinova, ali uz izbjegavanje neželjenih električnih smetnji. To je dovelo do pojave PGA (eng. m>Pin-Grid-Array) pakovanja, koje omogućava smještanje većeg broja veza na manju površinu. Koristi se i više slojeva keramike, a kod Pentium procesora i posebni keramički odvodnici toplote.
Sljedeća faza je pojava pakovanja LGA (eng. Land Grid Array), PLGA (eng. Plastic LGA) i OLGA (eng. Organic LGA) u kojima se keramika zamjenjuje plastikom i organskim materijalima. U ovom periodu počinje se koristiti pakovanje u obliku kertridža koje omogućuje smještanje keš memorije i ostalih čipova na različite načine u zavisnosti od sistema kome je procesor namijenjen. Ovdje se umjesto pinova koristi tzv. SECC (eng. Single Edge Cartridge Connector) veza. Mikroprocesori u mobilnim uređajima koriste tzv. mikro varijante pakovanja koje imaju nizak profil procesora i veću gustinu kontakata.
Postoje i drugi načini pakovanja kao što je BGA (eng. Ball Grid Array) koji ima kontakte u obliku loptica koje se užljebljuju za podnožje. BGA ima manju indukciju i veću gustinu povezivanja kontakata.
Za povezivanje čipova često se koristi i FP MLC (eng. Flip-Chip Multi-Layer Ceramic). Ova tehnologija za veze procesorske matrice koristi kompletnu površinu matrice. Za supstrat se koriste ili organska jedinjenja ili različite kombinacije stakla i keramike koje postižu najbolju toplotnu provodljivost, odnosno najbolje hlađenje.
2.6. Časovnik, riječ i magistrala < Index > 2.8. Organizacija centralnog procesora
 |
 |
 |
 |
 |
 |
